核心材料
光刻胶(Photoresist)是一种对光敏感的混合液体,是微电子技术中微细图形加工的关键材料,由光引发剂(光增感剂、光致产酸剂)、光刻胶树脂、溶材料剂、单体(活性稀释剂)和其他助剂组成。
从化学反应机理上看,光刻胶可分为负性和正性两类。其中,负性光刻胶在显影时,由于易变形和膨胀,通常情况下其分辨率只能达到2µm,更适用于低成本低价质量的芯片;而正性光刻胶分辨率对比度高,更适用于小型图形,高端光刻胶以正性为主。按应用领域,光刻胶可分为PCB光刻胶、LCD光刻胶、半导体光刻胶。而下文将主要围绕半导体光刻胶展开描述。
数十年里,半导体行业的迅猛发展离不开光刻工艺的进步,而光刻工艺必然也离不开光刻机、光源、光刻胶等关键设备和材料的跟进。
半导体光刻工艺需要经历硅片表面脱水烘烤、旋转涂胶、软烘、曝光、曝光后烘烤、显影、坚膜烘烤、显影检查等工序。而在光刻过程中,光刻胶则被均匀涂布在衬底,经过曝光、显影与刻蚀等工艺,将掩膜版上的图形转移到衬底上,形成与掩膜版完全对应的几何图形。光刻胶在其中起到的作用,主要是保护底层材料不被后续工艺刻蚀和将掩膜板图形转移到基片上。
据了解,光刻工艺约占整个芯片制造成本的35%,耗时占整个芯片工艺的40-50%,是半导体制造中最核心的工艺。而光刻胶是光刻工艺中不可或缺的核心材料,在半导体制造环节有着重要作用,并被誉为“半导体材料皇冠上的明珠”。
各“线”神通
一直以来,摩尔定律的进步始终驱动着半导体行业的发展,半导体光刻技术的进化也牵动着光刻胶材料不断革新,其中光刻胶曝光波长也在不断地缩短以满足需要。
按曝光光源波长来分,如今的半导体光刻胶可主要分为六大品类,分别为紫外全谱光(300~450nm波长)、g线(436nm波长)、i线(365nm波长)、KrF(248nm波长)、ArF(193nm波长)、以及目前最前沿的EUV光刻胶(<13.5nm波长)。通常来讲,波长越短加工分辨率越佳,能制造的芯片工艺越先进,技术难度也越高。
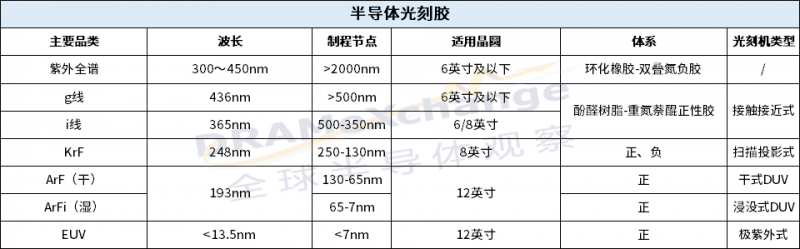
其中, g线、 i线光刻胶分别适用于436nm、365nm的波长光源,目前已成熟应用于汽车电子、MEMS、平板等领域。
KrF光刻胶适用于248nm波长光源,主要应用于3D NAND堆叠架构中。NAND工艺已逐渐从2D转向3D、4D堆叠架构,随着堆叠层数的增加,光刻次数也在递增,相应光刻胶的用量随着光刻次数的增加而大幅增长,KrF光刻胶的使用量将显著提升。
ArF光刻胶适用于193nm波长光源,主要用于逻辑芯片和高端存储芯片的制造,可大致分为干式和浸没式,ArF干式主要应用于130-65nm光刻工艺,而ArFi浸没式主要应用于65-7nm光刻工艺。据悉,ArFi光刻胶主要用于先进制程中的多重曝光过程,其需求量为普通光刻胶的2-4倍。
EUV光刻胶则使用波长为13.5nm的紫外光,主要用于7nm或更小逻辑制程节点的关键制造工序中,其用到的设备EUV光刻机,目前只有荷兰ASML能制造。目前EUV光刻胶仍处于应用早期,未来有望成长为光刻胶最核心的细分市场之一。
剑指高端
众所周知,光刻胶产业的壁垒主要在于配方和经验的长期积累、原材料的稳定供给、客户黏性和认证周期长、前期资金和人才投入大。
拥有百年历史的光刻胶,如今已形成独属于自身的产业格局。多年来,半导体光刻胶市场主要以日美厂商为主导,从产品种类、产能规模上来看,国内厂商还存在较大差距。不过近几年,随着国产替代“浪潮”的推动下,国内光刻胶瓶颈正在不断被突破,同时,南大光电、上海新阳、容大感光、北京科华(彤程新材)、晶瑞电材、汉拓光学(徐州博康)、厦门恒坤等众多企业开始崭露头角。
当前不少光刻胶企业致力于转向中高端光刻胶市场。其中,在高端光刻胶EUV方面,目前只有日本合成橡胶(JSR)、信越化学(SEC)、东京应化(TOK)等日本厂商完成了对EUV的量产,国内来看,上海新阳已经开启了EUV研发道路。
具体来看,南大光电的193nm ArF光刻胶已在下游客户存储芯片50nm和逻辑芯片55nm技术节点的产品上通过认证,其中一款产品已达到商用水平并实现销售;晶瑞电材KrF高端光刻胶部分品种已量产;上海新阳ArF干法光刻胶在验证阶段,其KrF光刻胶已有销售,上海本部也已建设部分光刻胶生产产能,合肥项目尚在建设中,尚未投产。
而容大感光此前在回复深交所《关注函》时表示,目前公司显示用光刻胶、半导体光刻胶的品质性能仅能满足中低端客户的要求,要开发中高端客户需要的产品尚存在技术瓶颈。目前公司半导体光刻胶主要是指g/i线正性光刻胶、负性光刻胶及配套的化学品。虽然这些光刻胶在国内属于领先水平,但公司对于中高端光刻胶开发尚存瓶颈。

非一日之功
作为一个劳动、资本和技术高度密集型的产业,半导体光刻胶技术的进步不仅需要科研人员坚持不懈地研发,还需要相关上下游企业共同努力。
从各大光刻胶企业的发展路线来看,随着半导体光刻工艺技术不断更新,以及芯片制程节点不断缩短,高端半导体光刻胶将成为28nm、14nm及10nm以下制程的关键,也是企业研发的目标。
而在半导体光刻胶这条赛道上,海外企业的领先步伐也让国内企业牟足了劲头,不过所谓炼成一技非一日之功,国内光刻胶企业仍需不断积累,未来任重而道远。