引言
近年来,半导体行业最为火热的话题非宽禁带半导体莫属,如碳化硅(SiC)。由于其优越的物理和电气特性,如高能量带隙(eV),高临界击穿场强(MV/cm)和高热导率(W/cm·K)等,在硅基半导体叱咤风云数十载的情况下逐渐活跃在大众视野。碳化硅器件相比于传统硅基,具有更低的漏源极通态电阻(RDS,on)、寄生电容和反向恢复电荷(Qrr),这使得变换器能够在更高频率下拥有更低的损耗。
和硅基的相似,碳化硅MOSFET也包含了一个内部固有的pn二极管,但由于其相对反向恢复电荷更低,其性能更优。尽管如此,碳化硅MOSFET的体二极管仍然在开关损耗中占比很大,并且在高温高电流下性能会有所下降。因此,有时通过反并碳化硅肖特基势垒二极管(SiC SBD)来提高开关性能,近乎为零的反向恢复特性,可是在高电压下会由于器件的输出电容而产生浪涌电流,从而增加整体开关损耗。那到底如何看待“体”二极管和“外部”SBD呢?
pn结二极管和肖特基势垒二极管
下面是pn结二极管和肖特基势垒二极管的结构示意图:
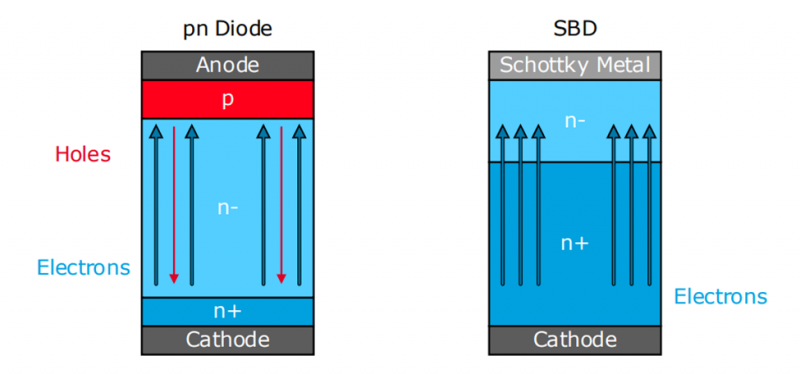
我们都知道在p掺杂和n掺杂处会形成pn结,形成一个pn结二极管,如上左图。当施加正向偏压时,n区的自由电子和p区的空穴流动,形成电子-空穴对,由于电子和空穴在导电时都携带电流,所以pn结二极管称为双极性器件。而肖特基势垒二极管是通过金属层和n掺杂半导体直接接触而形成,如上右图。由于没有p掺杂的存在,传导过程中不涉及空穴 而是由电子携带电流,故SBD称为单极性器件。
硅基pn二极管正向压降通常在0.7V左右,而SBD为0.3V左右。相对于硅,碳化硅由于具有更宽的带隙,意味着电子从价带移动到导带需要更大的能量,所以碳化硅基pn结二极管正向压降比硅基的高很多。由于这个原因,碳化硅基的二极管器件构成一般为肖特基势垒型而不是pn结二极管。另外 由于没有pn结的原因,硅基SBD的击穿电压要低很多,但碳化硅的高击穿场强使得SBD的击穿电压得以提高。
MOSFET中的体二极管示意图如下:
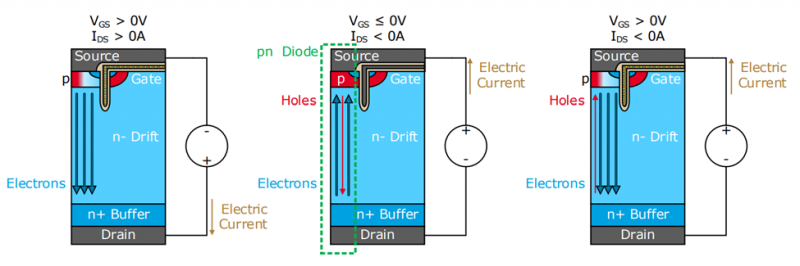
当对MOSFET施加正栅极电压时,p掺杂区域偏置,通道打开。电流可以通过器件从漏极流向源极(如左图)。MOSFET的p掺杂区域和n掺杂区域形成pn结二极管(体二极管),当MOSFET反向偏置时,体二级管变为正向偏置(如中图)。
由于体二极管和MOSFET的漏源极通道反向平行,所以其行为随着栅极电压的变化而显著变化。如果MOSFET通道关闭(VGS≤0V),体二极管表现为典型的pn二极管,正向电压和电流呈指数关系(如中图)。当栅极电压为正时,MOSFET通道被部分打开,从而获得较低的阻抗路径(如右图),绝大多数电流由电子携带,使得其比单独导电的体二极管具有更低的电压降(如下图)。

不同类型二极管的关断行为
二极管的关断行为是电力电子电路中评估稳定性和开关损耗的一个关键点。上述pn结二极管和肖特基势垒二极管在关断时有着不同的表现。下面我们分别针对体二极管和反并联SBD的关断行为进行简单的讨论。
我们知道MOSFET中包含的三个寄生电容:栅源极电容Cgs,漏源极电容Cds和栅漏极电容Cgd。这三个电容参数可以得到输出电容(Coss=Cds+Cgd),输入电容(Cies=Cgs+Cgd)和反向传输电容(Cres=Cgd),这些电容都是与电压有关的非线性参数。同时,和MOSFET类似,反向阻断模式下的二极管可以等效为电容Cak。这些寄生参数在二极管关断过程中会引起除反向恢复外的额外电流。
-
-
1. 体二极管的关断过程
-
对于任何MOSFET,体二极管关断期间测量的电流(-ID/If)最多包含三个电流成分:
·反向恢复电流Irr
·寄生电容结电流ICj
·可能存在的寄生导通电流Ipto
我们从下面的示意图来逐个解释

首先,最直接的便是体二极管中由于电子-空穴对复合产生的反向恢复电流Irr,与关断前的电流呈正比,产生的反向恢复电荷Qrr在芯片中耗散,产生热量,我们称之为反向损耗Err。
其次,我们上述提到的寄生电容参数,仅有体二极管的前提下,Cj=Coss。由于关断过程中电压不断上升,将产生一个dv/dt,此时在结电容上将形成相应的位移电流ICj。

由此产生的电流存储在电容的能量为

我们可以粗略估算为,ECj=1/2*Cj*V2
然而,由于这是纯电容性的,除了电路中的微小电阻产生的损耗外,ECj没有产生真正的功率损耗。
再者,我们都知道SiC MOSFET具有较低的阈值电压以及较高的VGSoff(即接近于零,例如-4V),同时具有较高的开关速度引起的较高dv/dt,CGD形成的位移电流导致CGS被充电,通道会轻微打开,形成漏源极电流Ipto,从而产生相应的损耗,我们称之为Epto。
虽然这不一定会造成破坏,但这种短暂的传导会产生额外的损耗,而且并不总是均匀地分布在整个芯片上。如果允许多次的Ipto重复产生,可能会出现局部过热点。
下图是SEMIKRON 62mm的全碳化硅模块SKM350MB120SCH15(不带反并联SBD)的体二极管关断波形,测量是在600V和350A下进行的。我们可以看到此时的峰值反向恢复电流Irr*(包含最多三种成分)为-140A。

-
2. 反并联肖特基势垒二极管的关断过程
-
-
上面我们提到,由于肖特基势垒二极管属于单极性器件,所以其没有反向恢复行为。关断期间测量的电流(-ID/If)由两个电流成分组成:
-
-
·反向恢复电流Irr
-
·寄生电容结电流ICj
-
·可能存在的寄生导通电流Ipto
-
-
如下图,
-
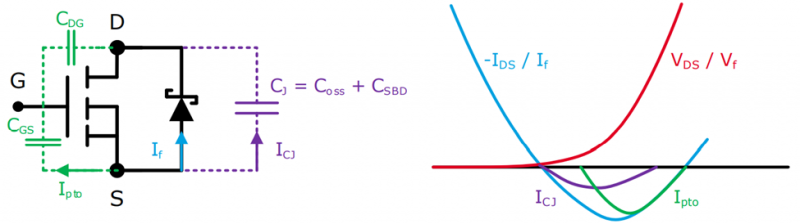
在正常运行时,SBD将携带绝大数的电流,而体二极管只携带极少量的电流,因此,体二极管基本上不会产生反向恢复电流。值得注意的是,如果产生寄生导通电流Ipto,因其是流过MOSFET,故其产生的损耗不能归结于SBD。
这里SEMIKRON在带有反并联SBD的全碳化硅模块中增加了一个新术语Err(MOSFET),用来描述ECj和Epto产生的能量,而不是真正的反向恢复能量。因为ECj是纯电容性的,对器件自热没有明显的影响,所以可以忽略。然而SEMIKRON规格书中没有从Err(MOSFET)中减去ECj,目的是为了更好地反映了真实的测量值。
下图是SEMIKRON 62mm的全碳化硅模块SKM350MB120SCH17(带反并联SBD)的二极管关断波形,测量是在600V和350A下进行的。我们可以看到此时的峰值反向恢复电流Irr*(包含最多两种成分)为-70A,由于缺少了反向恢复电流而变得低。

-
3. 单独肖特基势垒二极管的关断过程
如果单独使用SBD,那么二极管关断时电流只包含一个电流:
·反向恢复电流Irr
·寄生电容结电流ICj
·可能存在的寄生导通电流Ipto
如下图,

如上所述,此容性电流在芯片内不会产生损耗,因此,SiC SBD本身的开关损耗可以忽略不计。
下图是SEMIKRON 62mm的混合碳化硅模块SKM200GB12T4SiC2(Si IGBT + SiC SBD)的二极管关断波形。IGBT的寄生导通风险几乎为零,在二极管关断过程中只有SBD,并且反向恢复为零,而由IGBT和SBD寄生电容引起的电流仍然存在并且由于系统寄生参数可能产生一些振荡。

SEMIKRON模块规格书
下面我们来看看SEMIKRON是如何在不同类型模块中声明二极管反向恢复损耗的。
1. 全碳化硅模块(体二极管)
因为此类型模块仅依赖于体二极管,因此,为二极管指定了Irr,Qrr和Err。这些值包含了寄生导通的影响。但由于这两种损耗在同一个开关中产生,所以并没有进行具体区分。这些值也包含了结电容Cj造成的影响。
下图是SKM350MB120SCH15的部分参数,

其中,电流、di/dt和结温都会影响体二极管的反向恢复过程,在进行不同模块对比时需要注意。
2. 全碳化硅模块(带反并联SBD)
通常反并联SBD来改善开关过程,上述提到的Err(MOSFET)包含在动态曲线中,以及SBD的结电容Cj和存储电荷Qc也在规格书中给到,以便计算存储能量ECj。
下图是SKM350MB120SCH17的部分参数,
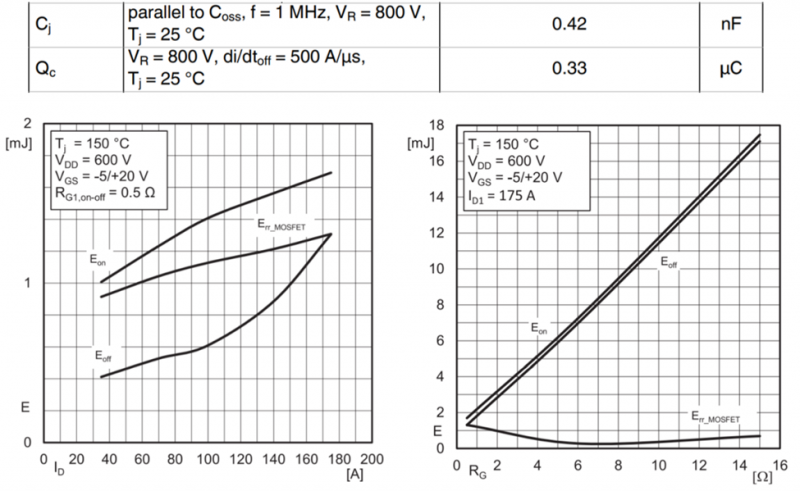
3. IGBT和SBD混合模块
上述可知,此时SBD基本没有损耗,故混合模块中只给出了结电容Cj和存储电荷Qc以便计算存储能量ECj。
下图是SKM200GB12T4SiC2的部分参数,
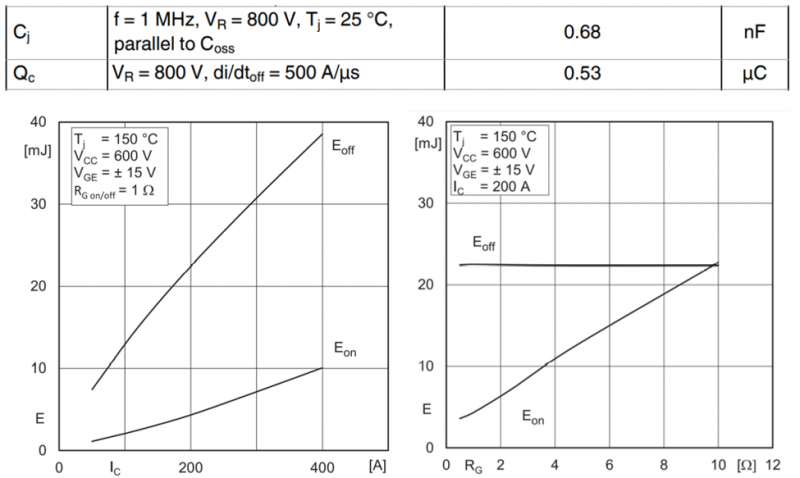
4. SBD模块
当单独使用SBD时,在规格书中只指定了Cj和Qc来描述动态行为。因为SBD没有反向恢复,因此单独使用时,仅SiC SBD (如整流器或者Buck/Boost变换器等)不需要其他动态值或者曲线。
下图是SKKE60S12(单个SBD模块)的部分参数,

结语
宽禁带半导体碳化硅使得高压SBD成为可能,SBD的关断行为不同于pn结二极管,但如上所述好处显而易见,特别是在高开关频率的应用中。而是否需要反并联SBD,那便需要结合实际应用,具体情况具体分析了,宽禁带的时代我想才刚刚开始……
本文主要是参考以下Application Note,在此向作者Daniel Prindle表示感谢!
参考文献:
Daniel Prindle, Semikorn Application “Dynamic Characterization of SiC Diodes”, 2022
Semikron Application Manual “Power Semiconductors”















