三菱电机持续不断地对集成SiC SBD(Schottky Barrier Diode)的SiC MOSFET芯片进行研发,MOSFET与SBD集成在同一芯片上,可以省掉续流二极管并使模块避免双极性电流引起的退化。本文对3.3kV集成SiC SBD的SiC MOSFET电气特性进行了研究并和传统3.3kV SiC MOSFET进行了对比。其主要电气参数例如JDS-VDS、击穿特性以及开关波形都没有明显的区别,这意味着使用集成SBD的SiC MOSFET技术障碍很小。已经取得的研究结果表明,集成SiC SBD的SiC MOSFET在下一代高压SiC功率模块上有很好的应用前景。
1 引言
三菱电机已经成功地实现了3.3kV全SiC功率模块商业化,该模块采用传统的SiC MOSFET和反并联SBD,应用在铁道牵引变流器上[1,2]。下一步,我们正在为下一代3.3kV SiC模块开发集成SBD的MOSFET[3,4]。与传统SiC MOSFET相比,集成SBD的SiCMOSFET可以省掉功率模块内部的续流二极管,避免SiC MOSFET的体二极管电流导致的双极退化。本文对传统SiC MOSFET和集成SBD的SiCMOSFET的电气特性进行了对比研究,结果表明集成SBD的SiCMOSFET在下一代3.3kV全SiC功率模块上有很好的应用前景。
2 MOSFET结构
图1为3.3kV传统SiC MOSFET和集成SBD的SiC MOSFET芯片截面图。对于集成SBD的SiC MOSFET,其MOS元胞内嵌入了电流反向流过的SBD电极。合理的集成SBD设计可以完全抑制双极性电流,并减小漏电流。为了进行对比,我们制作了相同有效面积的传统SiC MOSFET和集成SBD的SiCMOSFET芯片。

图1 传统MOSFET和集成SBD的MOSFET截面图
3 参数对比
3.1 静态参数
图2为传统SiC MOSFET与集成SBD的SiC MOSFET在175℃条件下正向特性参数的对比。图中展示了在不同栅极电压条件下的JDS-VDS曲线,其导通电阻比传统SiC MOSFET稍微高一些,这是因为在相同的有效面积下,与传统SiC MOSFET相比,集成SBD的SiC MOSFET的MOS沟道宽度要小一些。应该注意的是集成SBD的SiC MOSFET通态电阻的增加相对较小,这是因为肖特基端有较高的通流能力,使得SBD的面积相对很小。图3为传统SiC MOSFET与集成SBD的SiC MOSFET在结温175℃和栅极反向偏置条件下反向导通特性的对比,因为结电场分布不同,两条JSD-VSD曲线具有不同的拐点电压。由于两种载流子参与导电,传统SiC MOSFET的反向导通电阻变化很小。

图2 正向导通特性(175℃)
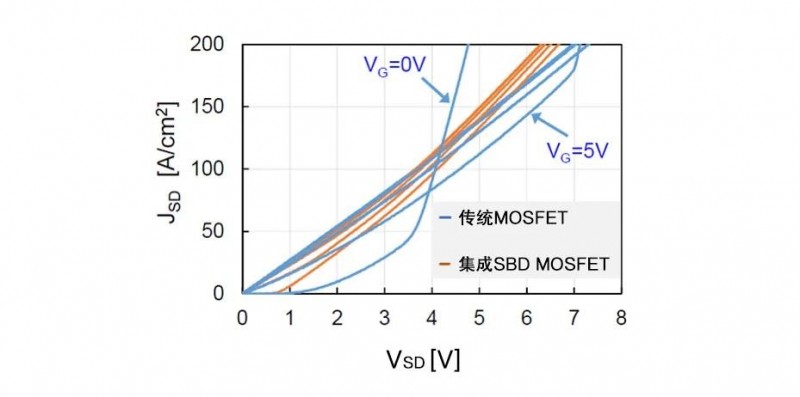
图3 反向导通特性(175℃,VGS=-7V)
图4为传统SiC MOSFET在结温175℃和栅极正向偏置条件下的反向导通曲线。因为集成SBD的SiC MOSFET反向导通电流是MOSFET沟道与SBD之和,所以反向电流密度JSD对栅极电压的依赖性相对较小。图5为传统SiC MOSFET与集成SBD的SiC MOSFET在25℃条件下击穿特性对比,可以看出集成SBD的SiC MOSFET漏极漏电流被很好地抑制,几乎与传统SiC MOSFET在同一水平。
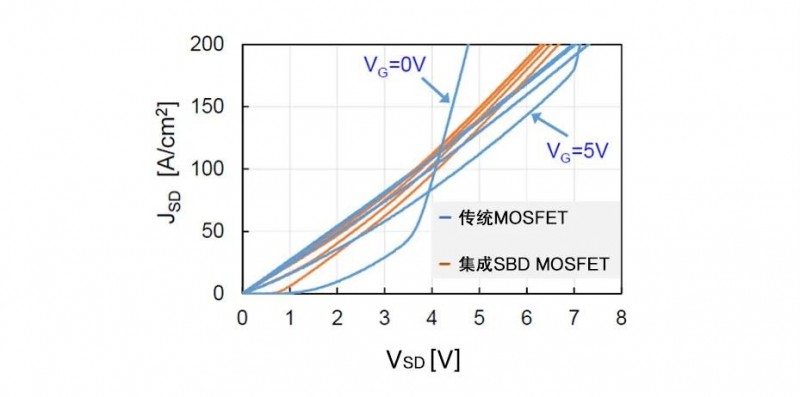
图4 反向导通特性(175℃,VGS=0~17V)
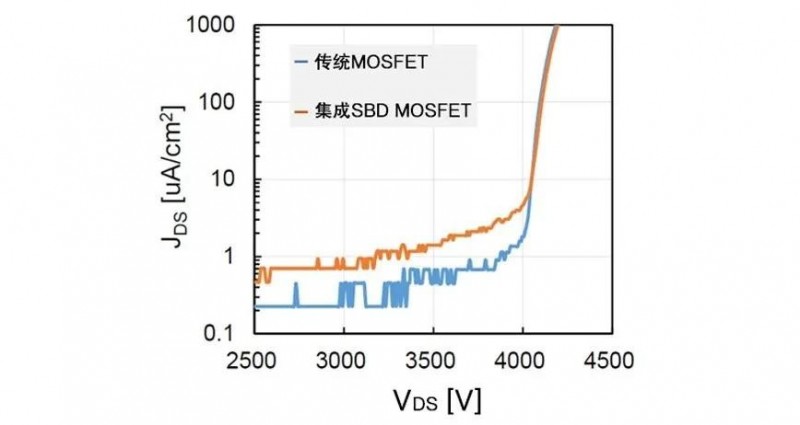
图5 击穿特性(25℃,VGS=-10V)
图6为传统SiC MOSFET与集成SBD的SiC MOSFET在频率100kHz、温度为25℃条件下极间电容与VDS之间的关系曲线。对于输入电容(Ciss)和反馈电容(Crss), 传统SiC MOSFET高于集成SBD的SiC MOSFET,这是由多晶硅电极侧和JFET的表面密度差异造成的。对于输出电容(Coss), 集成SBD的SiC MOSFET高于传统SiC MOSFET,这是因为集成SBD的MOSFET Coss值为传统SiC MOSFET与SBD的Coss之和。
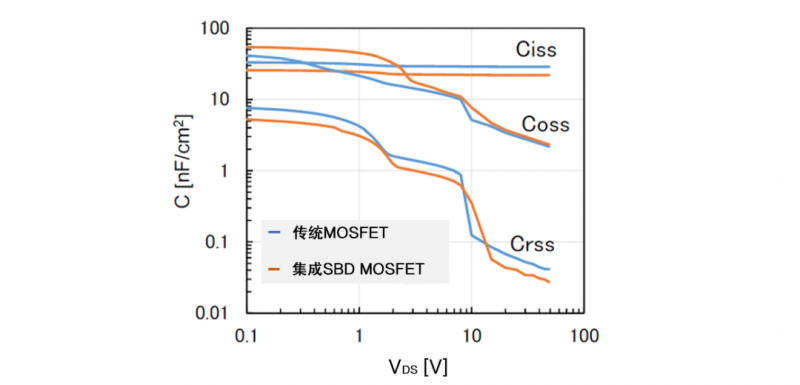
图6 极间电容VS VDS(25℃,100kHz)
3.2 动态参数
图7和图8是利用双脉冲测试法在175℃下测得的开关波形,图9为测试电路。在测试中,VDD设置在1800V,VGS设置为-7/17V。通过调整外部栅极电阻使di/dt保持一致,测得的传统SiC MOSFET与集成SBD的SiC MOSFET的开关波形几乎一致。传统SiC MOSFET与集成SBD的SiCMOSFET开通损耗(Eon)分别为22mJ/pulse和21mJ/pulse,关断损耗(Eoff)则分别为7.6mJ/pulse和6.0mJ/pulse。
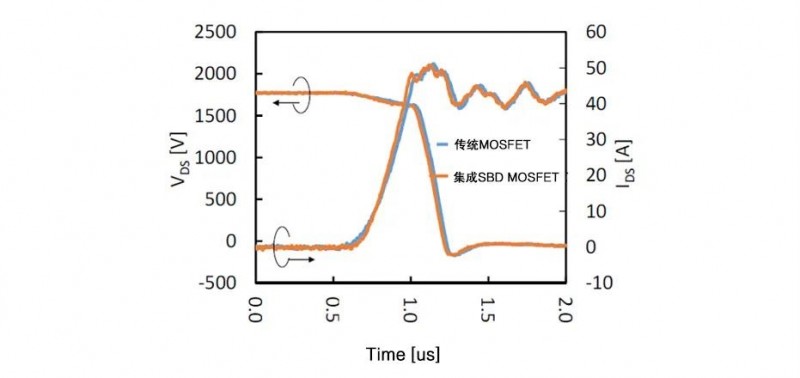
图7 开通波形(175℃,SBD作为续流二极管)
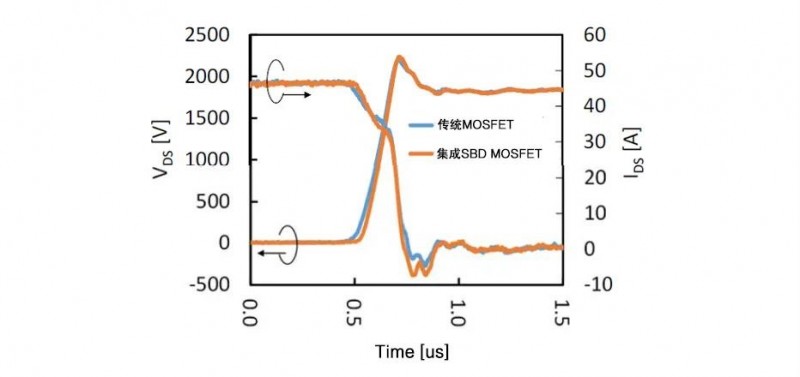
图8 关断波形(175℃,SBD作为续流二极管)
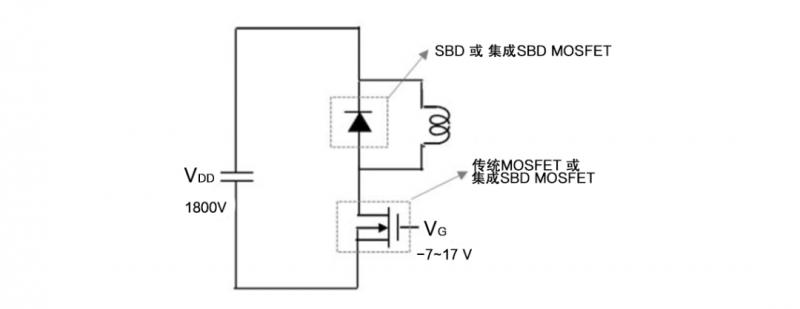
图9 开关测试电路
图10和图11为集成SBD的SiC MOSFET Eon和Eoff与栅极电阻之间的关系曲线,其Eon和Eoff随着栅极电阻的降低而线性降低。图12为传统SiC MOSFET模块与集成SBD的SiC MOSFET模块在175℃条件下的反向恢复电流波形对比,波形上没有明显的差异。此外,如文献5所述,传统SiC MOSFET的体二极管会参与工作,而集成SBD的SiC MOSFET反向恢复为单极性电流特性,因此集成SBD的SiC MOSFET可以降低反向恢复损耗。

图10 Eon与栅极电阻的关系图(Tj=175℃)
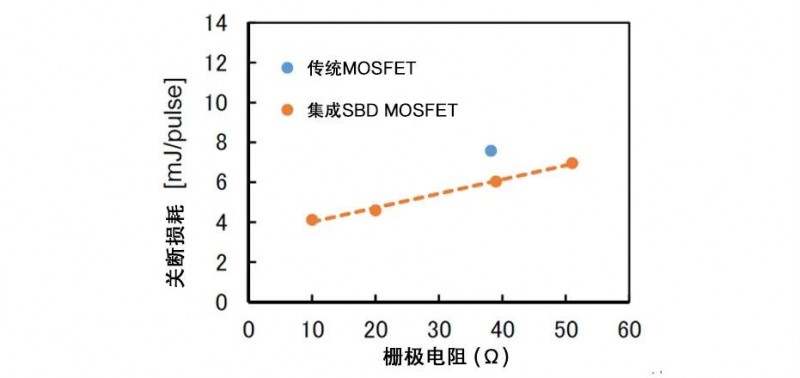
图11 Eoff与栅极电阻的关系
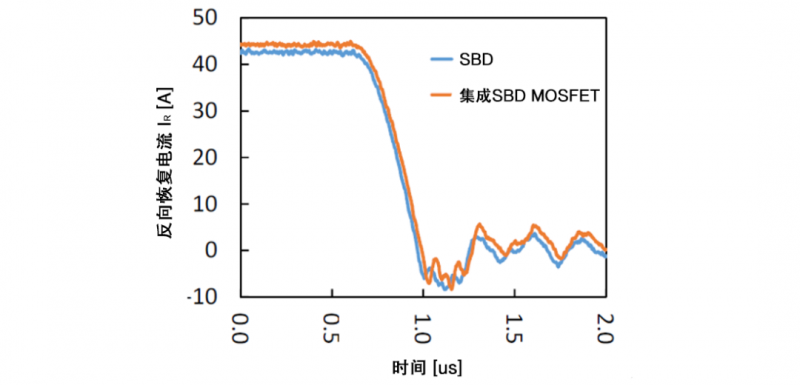
图12 反向恢复电流波形
4 结论
本文就3.3kV集成SBD的SiC MOSFET和传统SiC MOSFET的电气特性做了对比。如表1所示,两者的电气特性没有明显的差异。由于集成SBD的SiC MOSFET不会发生双极退化,因此在下一代高压SiC功率模块上有很好的应用前景。
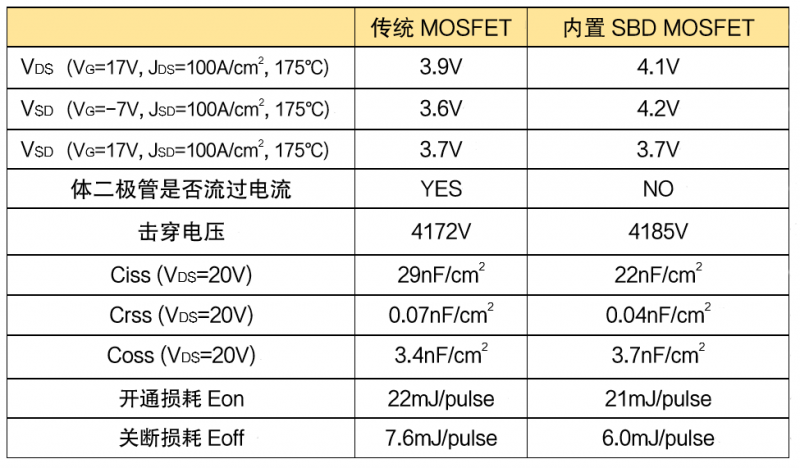
表1 传统MOSFET与集成SBD的SiC MOSFET参数对比
参考文献
[1] http://www.mitsubishielectric.co.jp/news/2014/0430.html
[2] K.Hamada, et al., “3.3kV/1500A power modulesfor the world’s first all-SiC traction inverter”, Jpn. J.Appl. Phys. 54 (2015)04DP07.
[3] S.Hino, et al., “Demonstration of SiC-MOSFETEmbedding Schottky Barrier Diode for Inactivation of Parasitic Body Diode”,Materials Science Forum, vol.897 (2017) pp.477-482.
[4] T.Tominaga, et al., “Superior Switchingcharacteristics of SiC-MOSFET embedding SBD”, ISPSD 2019, pp.27-30.
[5] T.Tominaga, et al., “Investigation on theEffect of Total Loss Reduction of HV Power Mpdule by using SiC-MOSFET EmbeddingSBD”, ICSCRM 2019, Mo-P-43.
















