ЫцзХвЦЖЏЕчзгВњЦЗЧїЯђЧсЧЩЁЂЖрЙІФмЁЂЕЭЙІКФЗЂеЙЃЌЮЊСЫдкИќаЁЕФЗтзАУцЛ§ЯТШнФЩИќЖрЕФв§НХЪ§ЃЌвђЖјЗЂеЙГіОЇдВМЖаОЦЌЗтзАWLCSPЁЃЫќОпБИИќЖрЕФЙІФмМЏГЩЁЂдкЬхЛ§ЁЂГЩБОКЭадФмЗНУцИќОпгХЪЦЃЌПЩвдгІгУдквЦЖЏЕчЛАЁЂРЖбРВњЦЗЁЂвНСЦЩшБИЁЂЩфЦЕЪеЗЂЦїЁЂЕчдДЙмРэЕЅдЊЁЂвєЦЕЗХДѓЦїКЭGPSФЃПщЪЙгУЁЃ
ЪВУДЪЧОЇдВМЖаОЦЌЗтзАWLCSPФиЃП
ДѓМвПЩФмБШНЯЪьЯЄBGAЃЌCSPОЭЪЧаЁаЭЕФBGAЃЌЭтаЮКЭЧђМфОрБШ BGAаЁЃЌЧђМфОраЁгк0.8КСУзЕФBGAГЦЮЊCSPЃЌЛђепЗтзАУцЛ§КЭРяУцаОЦЌЕФУцЛ§жЎБШаЁгк1.2ЁЃ
жСгкWLCSPЃЌОЭЪЧОЇдВМЖCSPЃЌМДЪЧДѓаЭЕФЕЙзАОЇЦЌЃЌжаМфУЛгадиЬхЃЌКИЧђжБНгжВгкЙшЛљВФЩЯЃЌвЛАуКИЧђМфОрЮЊ0.4жС0.8КСУзМфЁЃгЩгкОЇдВМЖаОЦЌЗтзАЕФУмМфОрЃЌЦфУєИаЖШдЖдЖГЌЙ§BGAЁЃ
ФЧУДЃЌдкзщзАОЇдВМЖаОЦЌЗтзАетжжОпгаКИЧђжБОЖаЁЁЂКИЧђМфОраЁЁЂЭтаЮГпДчаЁЕФдЊЦїМўЬиеїЪБЃЌГЇМввЊзЂвтЪВУДФиЃПЛЗЧђвЧЦїЬсГіСЫЪВУДНтОіЗНАИФиЃП
ОЇдВМЖаОЦЌЗтзАЕФзАХфСїГЬ
ФПЧАгаСНжжЙЄвеЃЌвЛжжЪЧЮ§ИрзАХфЃЌЕЋЮЊСЫБмУт“ЧХСЌ”Лђ“ЩйЮ§”ШБЯнЃЌЛЗЧђвЧЦїНЈвщВЩгУжњКИМСНўеКЕФЗНЗЈНјаазщзАЁЃ
ЙЄвеСїГЬЃК
-
ЪАШЁОЇдВМЖаОЦЌЗтзА
-
НўеКжњКИМС
-
ЬљзАОЇдВМЖаОЦЌЗтзА
-
ЛиСїКИНг
-
ЕзВПЬюГф(ШчгаашвЊ)
дкетРяЯШМЏжаЬжТлНўеКжњКИМССїГЬЃЌЛЗЧђвЧЦїНЈвщВЩгУжњКИМСБЁФЄНўеКЗНЪНЃЌМДдкдЊЦїМўЬљзАЧАНўеКвЛЖЈКёЖШЕФжњКИМСБЁФЄЃЌЪЙУПИіКИЧђЩЯИНзХвЛЖЈСПЕФжњКИМСЁЃ
ВЩгУжњКИМСБЁФЄНўеКЕФСНДѓгХЕуЃК
-
взгкАВзАМАВйзї
-
ЮоТлЪЧЮ§ЧІЛђЮоЧІКИЕуЖМФмЛёЕУНЯКУЕФШѓЪЊаЇЙћЃЌЕБШЛвВКЭЛиСїКИНгЙЄвеЯрЙи
ВЩгУжњКИМСБЁФЄНўеКЕФСНДѓЬєеНЃК
-
КИЧђИпЖШЕФВювьЁЂКИЧђЕФбѕЛЏГЬЖШМАЮТЪЊЖШБфЛЏгАЯьКИЧђЛёЕУжњКИМСЕФСП
-
№ЄаджњКИМСГжајБЉТЖдкПеЦјжа
жњКИМСгІгУЕЅдЊЪЧПижЦжњКИМСНўеКЙЄвеЕФживЊВПЗжЃЌЦфЙЄзїЕФЛљБОдРэЃЌОЭЪЧвЊЛёЕУЩшЖЈКёЖШЧвЮШЖЈЕФжњКИМСБЁФЄЃЌЪЙИїКИЧђеКШЁЕФжњКИМССПвЛжТЁЃ
вЊОЋШЗЮШЖЈЕФПижЦжњКИМСБЁФЄЕФКёЖШЃЌЭЌЪБТњзуИпЫйНўеКЕФвЊЧѓЃЌБиаыТњзувдЯТвЊЧѓЃК
1.ПЩвдЖрУЖ(Шч4Лђ7УЖ)дЊМўЭЌЪБНўеКжњКИМСРДЬсИпВњСП
2.жњКИМСгІгУЕЅдЊгІИУМђЕЅЁЂвзВйзїЁЂвзПижЦЁЂвзЧхНр
3.ПЩвдДІРэКмЙуЗКЕФжњКИМСЛђЮ§ИрЃЌЪЪКЯНўеКЙЄвеЕФжњКИМС№ЄЖШЗЖЮЇНЯПэЁЂЖдгкНЯЯЁКЭНЯ№ЄЕФжњКИМСЖМвЊФмДІРэЃЌЖјЧвЛёЕУЕФБЁФЄКёЖШвЊVдШ
4.еКШЁЙЄвеПЩвдОЋШЗПижЦЃЌНўеКЕФЙЄвеВЮЪ§вђВФСЯЕФВЛЭЌЖјЛсгаВювьЃЌЫљвдНўеКЙ§ГЬЙЄвеВЮЪ§БиаыПЩвдЕЅЖРПижЦЃЌШчЭљЯТЕФЫйЖШЁЂбЙСІЁЂЭЃСєЪБМфКЭЯђЩЯЕФМгЫйЖШЕШЁЃ
ЛЗЧђвЧЦїЕФЯпадБЁФЄЗѓСЯЦїПЩвдВњЩњвЛВуБЁБЁЕФжњКИМСЁЂКИИрКЭеГКЯМСЃЌгІЖдЕЅЖРЛђШКзщНўеКОЇдВCSPЃЌНЋашвЊЕФВФСЯСПЭПЗѓЕНКЯЪЪЕФЧјгђЩЯЁЃ
ЫќжївЊгЩСНИіВПЗжзщГЩЃЌЙЬЖЈВЛЖЏЪЂдижњКИМСЕФдуЃЌБмУтжњКИМСГжајБЉТЖдкПеЦјжаЃЛКЭПЩвдРДЛижБЯпдЫЖЏЁЂОпгаВЛЭЌЩюЖШЕФжњКИМСХЬЁЃ
жњКИМСВлФкЕФжњКИМСВЛЖЯВЙГфЕНЕзЯТРДЛидЫЖЏЕФжњКИМСХЬФкЃЌЮШЖЈКѓЃЌжњКИМСКёЖШЯрЕБгкИУХЬЕФЩюЖШЁЃжЛвЊЪЙгУВЛЭЌЩюЖШЕФХЬзгЃЌОЭПЩвдЛёЕУВЛЭЌКёЖШЕФжњКИМСЃЌЪЪгІгкВЛЭЌИпЖШЕФКИЧђЁЃ
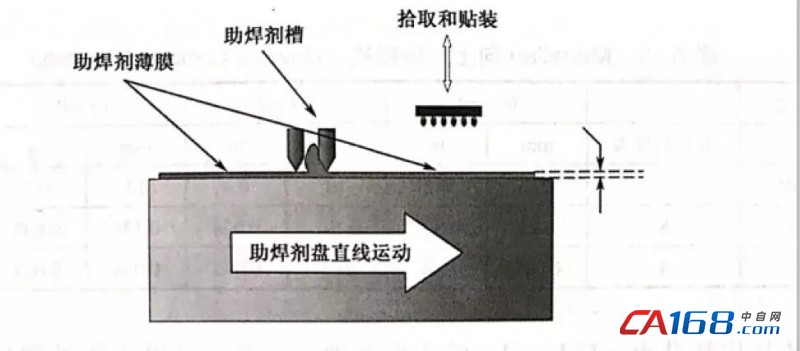
ЯпадБЁФЄЗѓСЯЦїЕФгХЪЦЃК
-
ЯпаЭЧ§ЖЏПЩШЗБЃБЁФЄКёЖШОљдШМАПЩжиИДад
-
ПьЫйзЊЛЛЕФжњКИМСХЬМАЩюЖШПижЦ(ЮоашЕїећ)
-
зюЖрПЩ7жсвЛЦ№НјааШКзщНўеК
-
ЕфаЭЕФ№ЄГэЖШ10KжС28.5KРхВД
-
ПЩБрГЬЕФЛиЙЮбЛЗДЮЪ§ЪБМф
-
ПЩБрГЬЕФНўеКЭЃСєЪБМф
-
ПЩБрГЬЕФЮЌаоМрЪгЦї
-
ПьЫйЪЭЗХжЮОпЁЂвзгкЧхЯД
-
ЬиДѓШнСП(ФмЮЌГжИпДя8аЁЪБЕФдЫзї)
-
вдЬљзАжсДЅПиИагІРДШЗШЯНўеК

ЛЗЧђвЧЦїЕФFuzionSCЦНЬЈЃЌЪЧзЈУХЮЊгІЖдЯШНјЗтзАзщзАЖјЩшМЦЕФЃЌУПЬЈЛњЦїзюЖрХфБИ2ИіЯпадБЁФЄЗѓСЯЦїЃЌФмИпЫйДІРэОЇдВМЖCSPзщзАЁЃ
FuzionSCЬљЦЌЛњСНДѓЯЕСа


-
-
-














